
 |
||
|
Senior Member
   加入日期: Mar 2004 您的住址: 長沙
文章: 1,365
|
台積電再勝三星! 奪下Nvidia次世代GPU訂單
消息來源
台積電再下一城!繼昨日傳出獨家搶下蘋果A10處理器大單後,今天再傳好消息。有南韓媒體報導,繪圖晶片大廠輝達(Nvidia)已將次世代圖形處理器(GPU)下單給台積電,等於再次擊退三星。 南韓媒體《Business Korea》今天報導,有業界消息人士指出,輝達已決定將以台積的16奈米鰭式場效電晶體(FinFET)製程,量產次世代Pascal架構GPU,預計將在明年正式推出。 輝達是全球最大的顯示晶片廠商,這款新的晶片被視為可能是次世代繪圖市場的里程碑,因此三星與台積先前即不斷爭取GPU訂單,外界原先預期雙方可能會共同量產這款Pascal架構GPU。 但專家表示,由於三星開始切出生產GPU,與台積電展開競爭的時間僅有兩年,在缺乏經驗的情況下,輝達仍然選擇了合作長達20年的台積,這對於三星無疑是一大衝擊。
__________________
 Which one do you like to choose?
|
|||||||
|
|
|
*停權中*
加入日期: Feb 2011
文章: 346
|
那到底何時買的到?
 |
||
|
|
|
*停權中*
加入日期: Jun 2015 您的住址: 金一十大女支三
文章: 1,282
|
Pascal似乎也沒針對DX12硬體特化 HBM又被鎖死
沒有期待的價值 |
|
|
|
Advance Member
  加入日期: Jan 2003
文章: 357
|
引用:
這一點也不意外! 畢竟是合作多年的朋友, 設計的製造難處比較清楚. tsmc 這幾年是又快又穩. 還有, 樓上說 HBM 部分. 這是使用 TSV 3D 封裝技術, 未來的趨勢, 要如何鎖死!? 現在就等 tsmc 的 3D IC 封裝量產了. 這一局, 日月光 矽品等大封裝廠是大眼流口水, 吃不到, 也無能為力了. |
|
|
|
|
*停權中*
加入日期: Mar 2015 您的住址: 熱火隊地盤
文章: 2,703
|
引用:
不知道,之前板上不是有人說Hynix的產能被AMD包了,又有什麼專利限制問題. AMD搶占HBM專利NVIDIA明年死守GDDR5 後來三星明年量產HBM的消息傳出又有馬路社消息說三星用HBM誘惑NV轉單. |
|
|
|
|
Advance Member
  加入日期: Jan 2003
文章: 357
|
引用:
無腦記者寫出來的業界花絮! 還有, HBM 這名詞看起來很礙眼. 請板上稍有程度之士, 以 3D IC 封裝取代這稱呼, 或說 TSV 技術都行. |
|
|
|
|
Power Member
  加入日期: Nov 2004
文章: 693
|
不知何時開始對某些媒體習慣用另一角度來看...
拿到NV的訂單 能算是再勝三不爽? 會有這種匪夷所思的新聞 看來PCWATCH所說的 大概八九不離十(雖然人家說的很含蓄) 引用PCWATCH的「A9」記事 新トランジスタアーキテクチャを採用したiPhone 6sの「A9」 ファウンドリのFinFETプロセスで、現在採用できるのは、TSMCの16nmプロセスとSamsungの14nmプロセス。プロセスノードの数字は16と14で異なっているが、内容的にはかなり似通っている同世代のプロセス技術だ。SamsungとGLOBALFOUNDRIESは14nmプロセスで戦略提携をしており、SamsungとGLOBALFOUNDRIESの間では、比較的容易に製造を移すことができる。今回のA9はSamsung/GLOBALFOUNDRIESでの製造と言われている。ちなみに、Samsung/GLOBALFOUNDRIESからTSMCに製造を移す場合は、RTLからの論理合成であっても、最適化にかなり手間がかかる。 ... また、プロセスのゲートピッチ自体も短くできる。Samsung/GLOBALFOUNDRIESのゲートピッチは20nmの90nmに対して、78nmと特に短い。そのため、14/16nm FinFETでは、20nmプロセスに対して最大で15%までダイを縮小できる。特に、Samsungはダイを縮小できることを強調しており、A9がSamsung/GLOBALFOUNDRIESの14nmだとしたらその恩恵を享受できる。 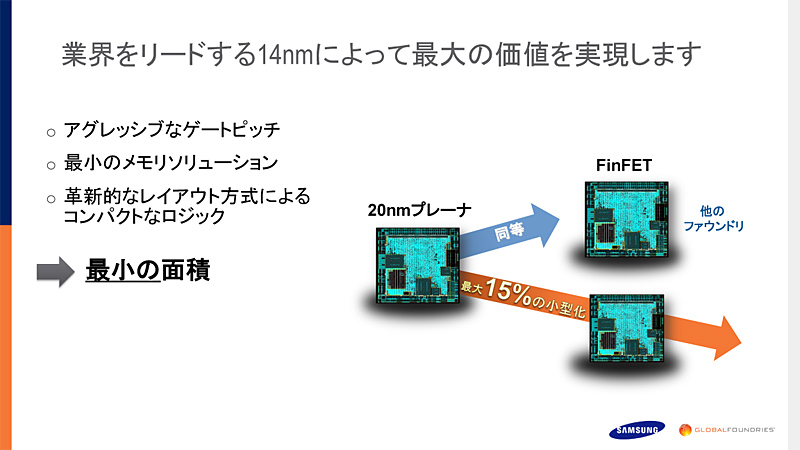 |
|
|
|
Power Member
  加入日期: Nov 2004
文章: 693
|
引用:
引用英文維基High Bandwidth Memory條目 https://en.wikipedia.org/wiki/High_Bandwidth_Memory The development of System in Package with High Bandwidth Memory began at AMD in 2008 to solve the problem of ever increasing power usage and form factor of computer memory. AMD and SK Hynix jointly developed it and started HBM's high volume manufacturing at TSV Packaging facility in Icheon, Korea from 2015. AMD commercialized 2.5D SiP with HBM in partners from the memory industry (SK Hynix), interposer industry (UMC) and packaging industry (Amkor Technology and ASE) to help AMD realize their vision of HBM.[5] 有聯電有日月光 就是沒台積電... |
|
|
|
|
Advance Member
  加入日期: Jan 2003
文章: 357
|
引用:
日月光是沒有能力做 3D 封裝的. 要 IC 晶圓廠才能. 2.5D 的門檻比較低, ASE 還能做. 但這只能撐幾年, 終極目標是 3D 封裝, 看來腳步也近了. 基本上, 就是記憶體商設計交給 IC 製造廠透過 TSV 達成堆疊, 然後, 這製造商不具更後端封裝的話, 轉包給 ASE 這樣的封裝廠. 並不是叫做 ASE 就能做 3D 封裝. 內文沒交代清楚. 若以一條龍方式, 晶圓代工規模, 可能只有 tsmc, UMC 這樣的公司 拿得到訂單. 還記得舊新聞: SPIL 嗆聲 tsmc---穿西裝的和穿工作 服的競爭. 目前看來是其來有自. 我想說的是台積電有專廠在做, 相關新聞都蒐得到! WIKI 這篇應該 要更新了. |
|
|
|
|
Power Member
  加入日期: Nov 2004
文章: 693
|
台積電未來會有
在SK海力士提供底層基板之後 現在個人不認為會釋出裸晶讓台積電作TSV 最多透過AMD拿些樣品研發而已 |
|
|